Анализ кривой качания: оценка поверхности кристалла
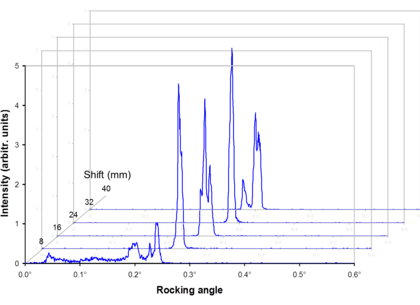
Поверхность пластин должна соответствовать очень высоким стандартам чистоты и однородности. Производители стремятся выращивать кристаллы с как можно меньшим количеством дефектов и дислокаций. В частности, для SiC устранение дислокаций открыло новые области применения данного материала.
Путем дооснащения дифрактометра Omega/Theta предметным столиком для картирования и двойным кристаллом можно измерить определенное отражение кривой качания от поверхности кристалла. Как показано на рисунке, полученное изображение показывает результат картирования поверхности SiC пластины. Внутренние области пластины отображают в 2-3 раза большую ширину кривой качания (по уровню FWHM). Это может быть связано либо с царапинами на поверхности, либо с дефектами, появившимися во время роста кристалла.
Приборы для оценки поверхности кристалла:
- Дифрактометрия одного кристалла
- Угловое разрешение 0.1 арксекунда
- Размер образца до 450 мм
- Полностью автоматизированное измерение


