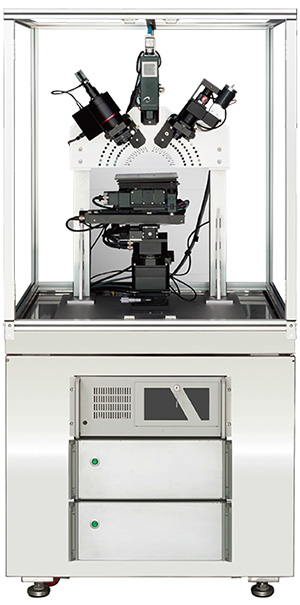
Спектральный поляриметр Elli-AAL
- Чрезвычайно точное измерение сверхмалой оптической анизотропии
- Отсутствие остаточной анизотропии подложки
- Проведение измерения одним нажатием (автоматические наклон, регулировка, картирование)
Производитель Ellipso Technology
Описание
Система для измерения анизотропии выравнивающего слоя
Данная система предоставляет эллипсометрические данные, которые достаточно точны для количественной характеристики сверхмалой оптической анизотропии выравнивающего слоя (AAL), такого как фотовыравнивающий слой. Такой слой оптически модулируется как двойной слой, состоящий из одноосного поверхностного слоя и изотропного объемного слоя. Определяются толщина каждого слоя, азимутальный угол, угол наклона оптической оси и двулучепреломление одноосного поверхностного слоя.
Отличительные особенности
- Чрезвычайно точное измерение сверхмалой оптической анизотропии
- Отсутствие остаточной анизотропии подложки
- Проведение измерения одним нажатием (автоматические наклон, регулировка, картирование)
- Простое в использовании программное обеспечение
Области применения
- Измерение и оценка оптической анизотропии выравнивающих слоев
Примеры анализа фотовыравнивающего слоя (PI) на стекле
- Типовой эллипсометрический отклик и параметры модели наилучшего соответствия для PI
Одноосный поверхностный слой: замедление = 0.148 нм; угол наклона = 5.57°; азимутальный угол = 28.8°; Δn = 0.0029; d = 50.97 нм
Изотропный объемный слой: n = 1.7094; d = 44.32 нм
- Сравнение измеренных значений со смоделированными (угол наклона изменяется)
Сервис анализа образцов
Компания Ellipso Technology предлагает аналитические услуги для анализа Ваших образцов
Компания Ellipso Technology предоставляет своим клиентам решение, включающее такие данные, как толщина, показатель преломления, коэффициент затухания и плотность тонкопленочных материалов, а также, другие возможные свойства, которые могут быть исследованы оптическим методом. Точность технологии и точность анализа Ellipso Technology пользуются доверием множества компаний и исследовательских институтов, а также учебных заведений.
Основываясь на знаниях и опыте, накопленных в ходе более чем 2000 запросов, полученных из различных областей за более чем десять лет, Ellipso Technology также предоставляет услуги по консультации клиентов, которые ищут решения вопросов, возникающих в процессе создания тонких пленок.
Небольшой список наших основных клиентов (локальных и зарубежных)
| Компании | Samsung Electronics, Samsung SDI, Samsung Electro-Mechanics, Samsung Corning, Samsung Advanced Institute of Technology, KCC, LG Electronics, LG Chemical, LG Siltron, Saehan Media, Orion Electric, SKC, Taehan Sugar, DongWoo Fine-Chem, Kolon, KC Tech, Ness Display, Jusung Engineering |
| Исследовательские центры | Корейский научно-исследовательский институт электротехнологии, Корейский институт машиностроения, Корейский научно-исследовательский институт стандартизации, Корейский научно-исследовательский институт электроники и телекоммуникаций, Корейский институт фундаментальных наук |
| Образовательные учреждения | Kyung Hee University, Seoul National University, Yonsei University, POSTECH, KAIST, Korea University, Sogang University, Ulsan University, Sungkyunkwan University, Hanyang University, Konkuk University, GIST, Chungju National University, Pusan National University, Ajou University, Inha University |
| Зарубежные компании |
HORIBA, Ltd. Miwa Opto, (Япония) Tohoku University (Япония) ASAHI GLASS (Япония) Ecole Polytechnique (Франция) ANWELL (Китай) INER (Institute of Nuclear Energy Research) (Тайвань) National Taiwan University (Тайвань) |
Стоимость услуги по измерению зависит от градации тестовых образцов для анализа:
- Единичный образец (подложка, пластина, стекло, т.п.)
- Несколько одинаковых образцов (например, 50 нм, 100 нм)
- Неизвестный образец с многослойной структурой
- PET пленки и новые материалы
В связи с тем, что для обработки запроса на точные измерения различных материалов должны работать самые опытные инженеры, номинальное количество образцов, которые мы можем обработать, составляет 5 образцов за один рабочий день. В некоторых случаях для измерения образца требуется всего 2-3 часа, так как на поверхности образцов после различных условий технологического процесса изготовления получаются самые разнообразные результаты.
Мы надеемся, что Вы понимаете данную ситуацию, а компания Ellipso Technology сделает все возможное, чтобы предоставить более точные и быстрые услуги в самый короткий срок.
Характеристики
| Замедление (σ) | 0.002 нм |
| Диапазон измерения азимутального и угла наклона оптической оси (σ)* | ≈ 0.05 – 0.50° |
| Скорость анализа | 12 сек/точка |
| Рабочая длина волны | 450 нм |
| Диаметр измерительного пятна | ≈ 4 мм |
| Перемещение по XYZ | Автоматическое (шаг 0.4 мкм) |
| Область картирования | 100 × 100 мм |
| Регулировка наклона образца | Автоматическая (шаг 0.001°) |
*Зависит от замедления
1. M.S. Park et al. "Quantitative Characterization of Uniaxial Anisotropy of Rubbed Polyimide Alignment Layer Using Reflection Ellipsometry," The 22nd International Display Workshops, Otsu, Japan, Dec. 9-11 (2015).
2. M.S. Park et al. "Characterization of Anisotropy Profile of Rubbed Polyimide Alignment Layer Using Reflection Ellipsometry," Digest of Technical Papers of IMID 2015, EXCO, Daegu, Korea, Aug. 18-21 (2015).
3. S.Y. Kim et al. "Evaluation of Alignment Layer Based on Ultra Small Optical Anisotropy Measurement," Summer Meeting of Optical Society of Korea, 381-382 (2015).
4. J.H. Lee et al. "Precise Measurement of Ultra Small Anisotropy of Rubbed Polyimide Using an Improved Reflection Ellipsometer," Digest of Technical Papers of IMID 2014, KINTEX, Seoul, (2014).
5. J.H. Lee et al. "Precise Measurement of Ultra Small Optical Anisotropy of Rubbed Polyimide Using an Improved Reflection Ellipsometer", J. Korean Opt. and Photonics, 26(4) 195-20ㅁ2 (2015).
6. S.Y. Kim "Ellipsometric Expressions for a Sample Coated with Uniaxially Anisotropic Layers," J. Korean Opt. & Photonics, 26(5) 275-282 (2015).
7. K.H. Lyum et al. "Study on Ultra-Small Optical Anisotropy Profile of Rubbed Polyimide Film by Using Transmission Ellipsometry," J. Opt. Soc. Korea, 18(2) 156-161 (2014).