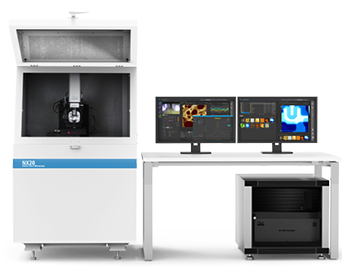
Высокоточный атомно-силовой микроскоп Park NX20 для анализа дефектов и исследования крупных образцов
- Анализ дефектов полупроводников
- Сканирующий диапазон: 100 мкм×100 мкм (50 мкм×50 мкм, 25 мкм×25 мкм)
- Предметный столик с функцией наклона
- Режим True Non-Contact (реальный бесконтактный режим АСМ)
- Автоматизированный интерфейс
- Z-детектор с низким уровнем шума
Производитель Park Systems
Особенности
Высокоточный атомно-силовой микроскоп Park NX20 – самый лучший инструмент в нанометрологии для анализа дефектов и исследования крупных образцов.
Идеальный выбор для анализа дефектов
Инженерам-исследователям, требуется получать надежные результаты и данные. Модель ParkNX20 имеет репутацию самого точного АСМ в мире для анализа крупных образцов, поэтому он получил широкое распространение в индустрии жестких дисков и полупроводников (статья "Исследование электрических свойств полупроводниковых устройств с помощью SCM и SKPM методов на атомно-силовом микроскопе").
Мощное решение для анализа дефектов
Данный АСМ оснащается компонентами уникальной конструкции, которые облегчают использование микроскопа при поиске дефектов устройств и разработке креативных проектов. Непараллельная конструкция обеспечивает получение данных с высоким разрешением, которые позволяют Вам уделить основное внимание решению исследовательских задач. Режим True Non-ContactТМ делает работу зонда более четкой и продолжительной, это экономит Ваши время и деньги на обслуживание.
Прост в работе даже для молодого специалиста
Park NX20 имеет самый удобный дизайн и автоматизированный интерфейс в индустрии, поэтому не потребуется тратить много времени и сил при работе с микроскопом и для обучения молодых специалистов. Это позволяет больше времени уделить исследовательской работе и решению сложных задач и обеспечивает своевременный и качественный анализ дефектов.
Режимы работы
Предметный столик с функцией наклона для получения подробных изображений боковин (боковых стенок)
Инновационная конструкция NX20 позволяет рассмотреть боковину и поверхность образца, измерить угол наклона профилей. АСМ становится еще более универсальным инструментом для проведения исследовательских работ и глубокого изучение внутренних деталей образца.
- Угол наклона: 10,15 и 20 град.
- Размер образца: 20×20 мм
- Толщина образца: 2 мм
Режимы работы
С широким диапазоном режимов сканирования и модульной конструкцией ParkNX20 располагает мощностью и гибкостью, которые требуются для реализации любого Вашего проекта
Стандартное изображение
- True Non-Contact AFM (реальный бесконтактный режим АСМ)
- PinPoint™ AFM
- Basic Contact AFM (основной контактный режим АСМ)
- Латеральная силовая микроскопия (LFM)
- Фазовое изображение
- Прерывистый (полуконтактный) режим АСМ
Электрические свойства*
- Сканирующая емкостная микроскопия (SCM)
- Режим проводимости АСМ (ULCA и VECA)
- Электрическая силовая микроскопия (EFM)
- Пьезоэлектрическая силовая микроскопия (PFM)
- Сканирующая микроскопия с зондом Кельвина (SKPM/KPM)
Общие свойства*
- Магнитная силовая микроскопия (MFM)
- Сканирующая температурная микроскопия (SThM)
- Силовая спектроскопия F-D
- Сканирующая туннельная микроскопия (STM)
- Силовая модулирующая микроскопия (FMM)
- Наноидентификация
- Нанолитография
- Наноманипуляция
* Опционально
Лидирующий в отрасли малошумный Z-детектор
Наши атомно-силовые микроскопы оснащены самыми эффективными в отрасли Z-детекторами с низким уровнем шума. Уровень шума не превышает 0,02 нм в широком диапазоне частот. Это позволяет выполнять топографическое измерение образца с высокой точностью, без смещения краев и калибровки. Поэтому Park NX20 экономит время и выдает отличные данные.
Точное топографическое изображение образца, полученное с помощью Z-детектора с низким уровнем шума
Отсутствие артефактов в результате сканирования АСМ на топографическом изображении с низким уровнем шума и обратной связью
- Используется сигнал Z-детектора низкого уровня шума для получения топографического изображения
- Низкий уровень шума Z-детектора 0,02 нм в широком диапазоне частот
- Отсутствие смещения краев (начальных и замыкающих)
- Выполняется только одна калибровка на заводе
Режим True Non-Contact сохраняет четкость показаний зонда
Наконечники (зонды) атомно-силовых микроскопов настолько хрупкие, что при их контакте с образцом происходит мгновенное снижение разрешения и качества изображения. При работе с мягкими и тонкими образцами зонд может повредить образец, это приведет к неточности измерений высоты профиля, повлечет рост затрат времени и денег. Уникальный режим True Non-ContactТМ АСМ существенно увеличивает разрешение и точность полученных данных при сохранении целостности самого образца.
Точная обратная связь за счет скоростного сервопривода оси Z в режиме True Non-Contact
| Режим True Non-ContactTM | Полуконтактное изображение |
 |
 |
|
|
Инновационный дизайн для решения самых современных задач
Точные атомно-силовые микроскопы для FA и исследовательских лабораторий
- Измерение шероховатости поверхности для сред и подложек
- Анализ и получение обзорных изображений дефектов
- Режим электронного сканирования высокого разрешения
- Измерение боковых стенок при изучении трехмерных структур
Точные, воспроизводимые измерения для повышения производительности измерений
- Бесконтактный режим для сохранения четкости зонда и обеспечения точности измерения шероховатости поверхности
- Быстрое получение изображений дефектов в бесконтактном режиме
- Система раздельного сканирования XY для измерения трехмерных структур
- Минимальный сдвиг и гистерезис с использованием компонентов, имеющих аналогичные температурные характеристики
Точная топография АСМ с применением малошумного Z-детектора
- Топографические измерения производятся самым современным промышленным Z-детектором с низким уровнем шума
- Технология True Sample TopographyTM без смещения краев или ошибок, вызванных изменением характеристик пьезоэлемента
- Точная регистрация высоты поверхности даже в процессе высокоскоростного сканирования
- Компактный латеральный сканер XY с синусоидальным алгоритмом сканирования при перемещении вперед
- Самый лучший критерий в отрасли - шаг сканирования при перемещении зонда вперед и назад не превышает 0,15%
Экономия затрат при работе в режиме True Non-ContactТМ
- Увеличенный более чем в 10 раз срок службы зонда при эксплуатации и отображении дефектов
- Минимальный износ зонда, гарантия получения высококачественного изображения с высоким разрешением в течение длительного периода времени
- Минимальное нарушение или изменение поверхности образца
Технологии Park AFM
Технические характеристики
| Сканер | Латеральный сканер XY | Z сканер |
| Консольный одномодульный XY-сканер с замкнутым контуром управления Сканирующий диапазон: 100 мкм×100 мкм (50 мкм×50 мкм, 25 мкм×25 мкм) 20-битный контроль положения и 24-битный датчик положения |
Направляющий консольный силовой сканер Сканирующий диапазон: 15 мкм (30 мкм) 20-битный контроль положения и 24-битный датчик положения |
|
| Обзор | Линза объектива | |
| Прямой осевой обзор поверхности образца и кантилевер В сборе с линзой объектива 10× (линза с 20-кратным увеличением предлагается дополнительно) Область обзора: 480×360мкм ПЗС: 1 Мегапиксель |
10×(0,21NA) линза со сверхдлинной рабочей дистанцией 20×(0,42NA) линза с длинной рабочей дистанцией высокого разрешения |
|
| Программа | NXP | NXI |
| Контроль системы и программа получения данных Регулируемые параметры обратной связи в режиме реального времени Управление скриптами с помощью внешних программ (дополнительно) |
Программа для анализа данных АСМ | |
| Электроника | Обработка сигнала | Встроенные функции |
| ADC: 18 каналов 4 высокоскоростных ADC канала (64 MSPS) 24-битный ADC для датчика положения сканера X, Y и Z DAC: 12 каналов 2 высокоскоростных DAC канала (64 MSPS) 20-битный DAC для позиционирования сканера X, Y и Z Максимальный размер данных: 4096×4096 пикселей |
3 канала гибкого цифрового фиксирующего усилителя Постоянная калибровка пружины (температурный метод) Цифровое Q-управление |
|
| Опции/Режимы | Стандартное изображение | Электрические свойства* |
|
True Non-Contact AFM (реальный бесконтактный режим АСМ) Basic Contact AFM (основной контактный режим АСМ) Латеральная силовая микроскопия (LFM) Фазовое изображение Прерывистый (полуконтактный) режим АСМ PinPoint AFM |
Режим проводимости АСМ Электрическая силовая микроскопия (EFM) Пьезоэлектрическая силовая микроскопия (PFM) Сканирующая микроскопия с зондом Кельвина (SKPM) Сканирующая емкостная микроскопия (SCM) |
|
| Общие свойства* | ||
| Магнитная силовая микроскопия (MFM) Сканирующая температурная микроскопия (SThM) Силовая спектроскопия F-D Сканирующая туннельная микроскопия (STM) |
Силовая модулирующая микроскопия (FMM) Наноидентификация Нанолитография Наноманипуляция |
|
| Дополнительные принадлежности | ||
| Пластины для образцов Акустическая камера с температурным контролем Ручной пробник для жидкостей Жидкостные элементы Столики с температурным контролем Внешний модуль с функцией наклона Модуль доступа сигнала |
||
| Предметный столик | ||
| Диапазон перемещения XY: 150 мм (200 мм в качестве опции) Диапазон перемещения Z: 25 мм Диапазон перемещения фокусировки: 15 мм Точное кодирующее устройство для всех осей (в качестве опции) |
||
| Крепление образца | ||
| До 150 мм (в качестве опции 200 мм) Вакуумные прорези для удерживания подложек образцов |
||
| Доступ внешнего сигнала | ||
|
20 встроенных портов ввода/вывода 5 TTL выводов: EOF, EOL, EOP, модуляция и смещение АС |
||
* Опционально
- Скачать проспект на высокоточный атомно-силовой микроскоп Park NX20
- Сканирующая емкостная микроскопия для исследования наноэлектроники с вакуумными каналами
- Исследование электрических свойств полупроводниковых устройств с помощью SCM и SKPM методов на атомно-силовом микроскопе
- Измерение контактной разности потенциалов поверхности методом SKPM
- Исследование различных образцов с помощью бесконтактного метода True Non-Contact на атомно-силовом микроскопе
- Исследование электрических свойств полупроводниковых устройств с помощью SCM и SKPM методов на атомно-силовом микроскопе
- Измерение электропроводимости пленки из углеродных нанотрубок с помощью проводящей зондовой атомно-силовой микроскопии (CP-AFM)
- Пьезоэлектрическая силовая микроскопия: многослойный керамический конденсатор
- Наномеханический режим измерений PinPoint для количественного анализа модуля упругости материалов: увеличенная скорость анализа
- Получение фазовых изображений высокого разрешения полимерной тонкой пленки, нанесенной на золото