Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Измерение контактной разности потенциалов поверхности методом SKPM
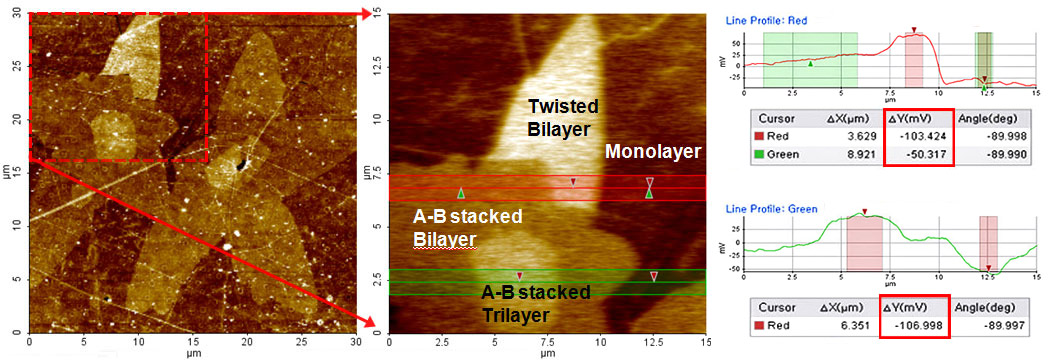
Сканирующая микроскопия с зондом Кельвина (SKPM) была представлена как метод для измерения локальной разницы потенциалов между проводящим наконечником кантилевера для атомно-силовой микроскопии (АСМ) и поверхностью исследуемого образца.
Таким образом, получается карта поверхности образца с локальным распределением потенциала на ней. Поскольку первое представление о методе было в Nonnenmacher [1], SKPM использовался как уникальный метод для измерения работы выхода электронов при исследовании металлических или полупроводниковых поверхностей и устройств. С недавних пор метод SKPM также используется для анализа электрических свойств органических материалов и устройств [2 – 4], а также биологических образцов. Чтобы в дальнейшем не вводить Вас в заблуждение, ниже рассмотрены синонимы данного метода:
- SKPM: сканирующая микроскопия с зондом Кельвина
- KPFM: силовая микроскопия с зондом Кельвина
- SSPM: сканирующая микроскопия поверхностного потенциала
- SKFM: сканирующая силовая микроскопия Кельвина
- SPM: микроскопия поверхностного потенциала
- SP-AFM: атомно-силовая микроскопия поверхностного потенциала
В данной статье далее будет использоваться акроним SKPM, поскольку именно он является наиболее распространенным. Термин «сила Кельвина» относится к сходству между технологией микроскопии и технологией макроскопии, которая представляет собой метод зонда Кельвина. И хотя методология немного отличается, измеренное значение эквивалентно для обеих технологий. Для наглядности данное замечание будет относиться только к методу SKPM.
Основы сканирующей микроскопии с зондом Кельвина (SKPM)
Сканирующая микроскопия с зондом Кельвина (SKPM) измеряет контактную разницу потенциалов (CPD) между проводящим кантилевером атомно-силового микроскопа и поверхностью образца. Значение CPD определяется по следующей формуле:

где φtip и φsample работа выхода для кантилевера и для образца, а e – заряд электрона.
Разница между энергетическими уровнями Ферми для кантилевера и поверхности образца вызывает электрическую силу по мере приближения кантилевера к образцу.
На рис. 1 показана энергетическая диаграмма для кантилевера и поверхности образца, когда работа выхода для них различная. Рис. 1a показывает энергетические уровни кантилевера и образца когда они отведены на некоторое расстояние друг от друга, но этого расстояния все еще достаточно для туннелирования электронов; равновесное состояние требует, чтобы уровни Ферми находились в устойчивом состоянии.
После электрического контакта уровни Ферми выравниваются за счет протекающего электрического тока, а вся система в целом достигнет равновесного состояния (рис. 1b). Кантилевер и поверхность образца будут заряжены, вследствие чего получится очевидная контактная разница потенциалов (стоит отметить, что энергетические уровни Ферми выровнены, однако вакуумные энергетические уровни различны).
Электрическая сила воздействует на область контакта из-за CPD. Как показано на рис. 1c эта сила может быть сведена к нулю. Данная технология и является кельвиновским методом, который основан не регистрации электрического поля между материалом образца и материалом кантилевера. Электрическое поле может изменяться за счет напряжения VCPD, которое подается на образец относительно кантилевера. Если подаваемое внешнее напряжение смещения (VDC) имеет такую же амплитуду, что и VCPD, но с противоположным знаком, то поверхностный заряд в области контакта устраняется.
Прикладываемое значение VCPD обнуляет электрическую силу и имеет такое же значение, что и разница работ выхода между кантилевером и образцом. Это позволяет определить потенциал на поверхности образца при известном потенциале на кантилевере.
Рис. 1. Энергетические уровни Ферми кантилевера (tip) и образца (sample) в различных случаях: (a) – кантилевер и образец разведены на расстояние d, электрический контакт отсутствует; (b) – кантилевер и образец находятся в электрическом контакте; (c) – к системе «кантилевер-образец» приложено внешнее напряжение смещения для обнуления CPD и, как следствие, электрической силы. EV - уровень энергии в вакууме, Efs и Eft – уровни Ферми для образца и кантилевера соответственно.
Прикладывая к кантилеверу напряжение переменного тока (VAC) и напряжение постоянного тока (VDC), с помощью SKPM имеется возможность измерять работу выхода на образце. VAC генерирует колеблющееся электрическое поле между кантилевером и поверхностью образца, а VDC обнуляет электрические силы, которые возникают вследствие контактной разницы потенциалов между кантилевером и образцом. Электростатические силы (FES) в данной системе определяются следующим выражением:

где z – это направление нормали к поверхности образца, ΔV – разность потенциалов между VCPD и напряжением, приложенным к кантилеверу, dC/dz – градиент емкости между кантилевером и поверхностью образца.
Внешний потенциал VExt – это дополнительное напряжение, которое прикладывается либо к кантилеверу, либо к образцу; знак перед этим значением объясняется ниже. Разница напряжений будет определяться следующим выражением [5]:

Амплитуда колебаний кантилевера (VAC) пропорциональна силе F. Подставляя уравнение (2.3) в уравнение (2.2) и объединяя слагаемые по частотам, получаем следующее выражение для амплитуды колебаний кантилевера:

Данное уравнение можно записать в виде трех отдельных выражений:

FDC отображает отклонение кантилевера в результате действия статических сил. Fω с частотой ω используется для измерения VCPD. F2ω используется для емкостной микроскопии [6]. Fω представляет собой компонент электрической силы с модифицированной частотой. Это также функция VCPD и VAC. Когда электростатические силы прикладываются к кантилеверу с помощью VAC с VExt, то дополнительные компоненты колебаний (из-за наличия электрической силы) будут наложены на механические колебания кантилевера.
Для измерения VCPD и извлечения Fω используется синхронный усилитель. Выходной сигнал с синхронного усилителя прямо пропорционален разнице между VCPD и VExt. Значение VCPD может быть измерено за счет прикладывания VExt к кантилеверу и, таким образом, выходной сигнал на синхронном усилителе обнуляется и Fω достигает значения, равного нулю. Далее значение VExt получают для каждой точки на поверхности образца и по этим значениям строят карту распределения потенциала на поверхности исследуемого образца. Контактная разница потенциалов VCPD получается за счет следующей процедуры: напряжение постоянного тока VExt изменяют до тех пор, пока значение колебаний напряжения переменного тока на кантилевере на частоте ω не обнулится; в такой ситуации VExt = ±VCPD.
Когда внешнее напряжение смещения прикладывается к кантилеверу или образцу, оно изменяет их работу выхода. Следовательно, исходя из уравнения 2.1, знак VCPD будет изменяться в обоих случаях. Поэтому апостериорная разность напряжения постоянного тока (направление) определяется для обоих случаев как:
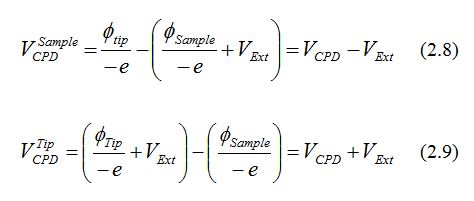
где уравнения 2.8 и 2.9 представлены для случаев, когда напряжение подается на образец и кантилевер соответственно, а VCPD обнуляется за счет внешнего напряжения, т.е. когда VExt = ±VCPD, где «+» и «-» относятся ко внешнему напряжению смещения, приложенному к образцу и кантилеверу соответственно.
Метод SKPM, используемый в атомно-силовых микроскопах компании Park Systems
В атомно-силовой микроскопии существует большое количество способов измерения методом SKPM. Компания Park Systems использует технологию двух частот (см. рис. 2). Синхронные усилители, установленные в контроллере, используются для модуляции по частоте: одна частота предназначена для колебания самого кантилевера и получения топографии поверхности (с помощью биморфного пьезоэлемента), а вторая частота напрямую усиливает сигнал на кантилевере до 17 кГц (обычно именно такая частота используется в SKPM).
Информация о топографии поверхности и потенциале поступает в АСМ на каждой из частот одновременно и два изображения формируются независимо. Это позволяет пользователю одновременно получить изображение с профилем исследуемой поверхности и карту с распределением потенциала по данной поверхности. Топография получается за счет поддержания постоянного расстояния между кантилевером и поверхностью образца, тогда как карта с потенциалом получается за счет прикладывания постоянного внешнего напряжения и измерения текущего потенциала на кантилевере.
Рис. 2. Схематичное отображение использования метода SKPM в атомно-силовых микроскопах
Для проведения измерений методом SKPM был выбран образец с нанесенными на него кремнием, алюминием и золотом. Чтобы измерить такой образец был выбран кантилевер типа NCHAu компании Nanosensors. Данный кантилевер имеет металлическое покрытие на обеих сторонах, а радиус его острия составляет менее 50 нм. Резонансная частота составляет 330 кГц, а жесткость пружины 42 Н/м. Поскольку кантилевер и исследуемый образец изготовлены из различных материалов, то между ними может возникнуть напряжение смещения (как показано на рис. 3e). Чтобы проводить измерения методом SKPM, данное смещение, которое возникает из-за амплитуды VAC, должно быть определено количественно. Для этого необходимо измерить калибровочный образец, например, высокоупорядоченный пиролитический графит (HOPG), работа выхода которого хорошо известна. Следует отметить, что разница между областями с алюминием и золотом должна быть постоянной в соответствии с приложенным направлением, потому что существует очевидная разница в работе выхода.
Рис. 3. На данном рисунке представлены: (a) – топография поверхности и (b) – значение VExt в присутствии напряжения смещения на поверхности образца в направлении вверх; аналогично (c) – топография поверхности и (d) – значение VExt в присутствии напряжения смещения на поверхности образца в направлении вниз. (e) – профиль значений VExt при направлении вверх (синяя линия) и вниз (зеленая линия). Размер каждого изображения 25 × 2.5 мкм.
Рисунок 3e показывает профиль линии с данными средних значений, полученных для 16 соседних точек вдоль оси Y. Металлические области имеют различные знаки контактной разности потенциалов, что подтверждает знаки вычитания и сложения в уравнениях 2.8 и 2.9 соответственно.
Анализ и воспроизводимость метода SKPM
Целью метода SKPM является получение значения работы выхода с поверхности образца, а не значения VCPD между кантилевером и образцом. Перед измерениями необходимо проводить калибровку по образцу с известным значением работы выхода электронов. Использование контрольного образца позволяет избавиться от потенциального электрического смещения, которое может возникнуть во время процесса измерения. После измерения образца, работы выхода кантилевера вычисляется по уравнению 2.10. В итоге, повторение данной процедуры несколько раз и последующего усреднения полученных результатов позволяет получать очень точные данные.

Рис. 4. Данные, полученные методом SKPM при использовании девяти разных кантилеверов при исследовании образца. На графике представлены значения, полученные для алюминия (оранжевые кружки), кремний (голубые квадраты) и разница значений между алюминием и кремнием (серые треугольники).
Исследуемый образец состоял из трех различных материалов: золото, кремний и алюминий. В качестве калибровочного образца была выбрана область с золотом, поскольку кантилевер имел такое же покрытие и изготовлен из такого же материала. Далее были получены значения работы выхода для алюминия и кремния. Теоретически рассчитанные значения данного параметра и полученные экспериментально значения представлены в таблице 1.
Таблица 1. Значения работы выхода: теоретические и экспериментальные (усреднено по 9 измерениям)
| Материал | Теоретическая работа выхода (эВ) | Измеренная работа выхода, (эВ) |
| Золото (Au) | 5.10 – 5.47 | 5.1 (фиксированное) |
| Кремний (Si) | 4.60 – 4.85 | 4.87 |
| Алюминий (Al) | 4.06 – 4.26 | 4.13 |
Подробные характеристики атомно-силовых микроскопов
Ссылки
[1] M. Nonnenmacher, M.P. Oboyle, H.K. Wickramasinghe, Appl. Phys. Lett. 58(1991) 2921.
[2] H. Hoppe, T. Glatzel, M. Niggemann, A. Hinsch, M.C. Lux-Steiner, N.S. Sariciftci, Nano Lett. 5 (2005) 269.
[3] T. Hallam, C.M. Duffy, T. Minakata, M. Ando, H. Sirringhaus, Nanotechnology 20 (2009) 025203.
[4] L.M. Liu, G.Y. Li, Appl. Phys. Lett. 96 (2010) 083302.
[5] R. Shikler, T. Meoded, N. Fried, B. Mishori, Y. Rosenwaks, J. Appl. Phys. 86 (1999) 107.
[6] S.V. Kalinin, A. Gruverman (Eds.), Scanning Probe Microscopy, Springer, New York, 2007.