Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Получение фазовых изображений высокого разрешения полимерной тонкой пленки, нанесенной на золото

Функциональные полимерные тонкие пленки имеют множество технологических применений, от оптоэлектроники до сенсоров. Их свойства, гибкость и недорогая подготовка делают их привлекательными для промышленности [1]. На свойства полимерных тонких пленок сильно влияют распределение, формы и состав мономеров отдельных макромолекул. По этой причине для разработки свойств полимера требуется методика характеризации, которая позволяет изобразить материал с высоким пространственным разрешением для точной визуализации морфологии полимера по наноразмерным и точным измерениям макромолекул [2].
Сканирующая электронная микроскопия (SEM) и просвечивающая электронная микроскопия с фильтрацией энергии (EFTEM) являются распространенными методами для характеристики полимерных тонких пленок. Тем не менее, SEM имеет низкое пространственное разрешение при визуализации наноструктурированных органических образцов, содержащих только легкие элементы, в то время как EFTEM имеет высокий уровень ложных повреждений из-за высоких ускоряющих напряжений, приложенных во время работы [3, 4].
Эффективным инструментом для преодоления этих проблем является атомно-силовая микроскопия (АСМ). АСМ является неразрушающим методом, который предоставляет изображения с высоким разрешением, необходимые для получения характеристик на уровне наномасштабов. Кроме того, этот инструмент может работать в различных режимах измерения, которые отображают свойства материала в дополнение к морфологической информации. Среди них режим фазового изображения – это мощный режим АСМ, используемый учеными и инженерами для изучения неоднородностей состава в полимерных материалах. Этот режим предоставляет дополнительную информацию для топографического изображения путем выявления локальных изменений свойств поверхности и состава исследуемых материалов.
В этом исследовании для характеристики тонких полимерных пленок, нанесенных на золото, использовался атомно-силовой микроскоп NX20 компании Park Systems в полуконтактном режиме измерений. Фазовое изображение высокого разрешения, полученное одновременно с топографическим изображением, показало, что изменения поверхности произошли после нагревания образца и приложения напряжения смещения постоянного тока к кантилеверу. Далее были измерены и оценены конформация и фазовое разделение полимерных доменов.
Эксперимент
Тонкая полимерная пленка, нанесенная на золото на кремниевой подложке, была нагрета до 230°C с помощью предметного столика с температурным контроллером. Кроме того, между кантилевером АСМ и поверхностью образца подавалось напряжение смещения постоянного тока в 1 В. С помощью NX20 одновременно получали топографию и фазовое изображение, используя полуконтактный режим измерения в условиях окружающей среды. Изображения были получены до и после того, как образец подвергся процессу нагрева и приложения напряжения смещения. В эксперименте использовался проводящий Ti-Pt кантилевер модели NSC36A от компании Mikromasch (номинальная жесткость пружины k = 1 Н/м, резонансная частота f = 90 кГц).
Результаты
В полуконтактном режиме кантилевер колеблется вблизи своей резонансной частоты, что позволяет его острию периодически касаться поверхности образца в нижней точке колебаний. Топографические изображения получают путем измерения изменений амплитуды колебаний кантилевера, вызванных силами притяжения Ван-дер-Ваальса во время сканирования, когда кантилевер механически колеблется вблизи своей резонансной частоты. Измеренные изменения компенсируются контуром обратной связи АСМ, который поддерживает постоянную амплитуду колебаний и расстояние от кантилевера до образца, за счет управления движением Z-сканера [5]. Фазовое изображение получают одновременно путем отслеживания фазовой задержки между сигналом, который управляет колебанием кантилевера, и выходным сигналом (см. рис. 1).
Рис. 1. Типовая схема работы в режиме получения фазового изображения [6].
В таблице ниже приведены топографические и фазовые изображения полимерной тонкой пленки до и после нагрева и приложения напряжения смещения. Топографическое изображение, полученное до воздействия, показывает гладкую поверхность образца, в то время как фазовое изображение показывает, что поверхность состоит из пластинчатых полимерных фибрилл, равномерно распределенных по поверхности.
С другой стороны, топография, полученная после воздействия нагреванием и напряжением смещения, показывает, что в центре сканируемой поверхности образовались два центральных выступа (внутренний и наружный выступы). Внутренний круглый выступ имеет высоту около 53 нм и диаметр в диапазоне от 1.4 до 2.0 мкм. Внешний круговой выступ имеет более низкую высоту около 30 нм и диаметр в диапазоне от 2.0 до 4.0 мкм. Окружающая область является относительно плоской со среднеквадратичной шероховатостью поверхности 0.8 нм. Сравнивая топографию и фазовое изображение, можно заметить, что ориентация пластинчатых фибрилл во внутреннем и наружном выступах переориентирована, и фибриллы выровнены по-разному как в выступах, так и на плоской поверхности.
Таблица 1: Топографические и фазовые изображения до и после нагрева до 230°C и приложения постоянного напряжения смещения в 1 В между кантилевером и образцом.
| Изображение | До воздействия | После воздействия |
| Топография |  |
 |
| Фаза | 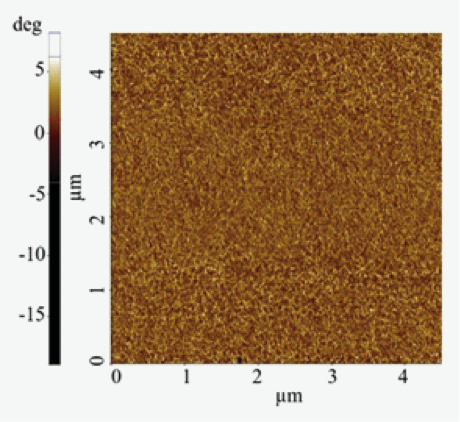 |
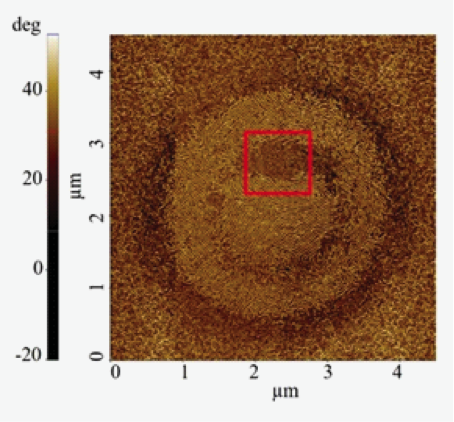 |
Рисунки 2a и 2b – это увеличенный вид и соответствующее трехмерное представление области, выделенной квадратом красного цвета на фазовом изображении в Таблице 1. Оба изображения ясно показывают отчетливые различия в выравнивании фибрилл: верхняя и нижняя части рисунка 2а отображают захваченные периодические фибриллы, выровненные в плоскости сканирования, в то время как пунктирная область в центре рисунка соответствует доменам с фибриллами, которые переориентированы в вертикальном направлении (перпендикулярно плоскости сканирования) после воздействия нагреванием и напряжением смещения.
На рисунке 2с показан соответствующий профиль поперечного сечения вдоль красной линии, полученный с помощью программного обеспечения для анализа изображений Park XEI для оценки размеров пластинчатых фибрилл, а также разделения фаз. Измеренная ширина пластинчатых фибрилл составляла приблизительно 26 нм, тогда как расстояние между соседними фибриллами составляло приблизительно 22 нм.
Рис. 2. (a) Увеличенный вид полученного фазового изображения (после обработки); (b) 3D вид анализируемой области; (c) Профиль поперечного сечения вдоль красной линии для анализируемой области.
Заключение
Данное исследование демонстрирует пригодность фазовой визуализации для характеристики тонких полимерных пленок. Фазовые изображения высокого разрешения, полученные в эксперименте, показывают значительные изменения поверхности тонких пленок полимера после того, как они подверглись нагреву и приложению напряжения смещения. Замечено, что во время нагрева и приложения напряжения смещения некоторые полимерные фибриллы выровнялись в вертикальной ориентации, а другие остались в плоскости. Кроме того, в плоскости фибрилл образованы домены различной ориентации.
Таким образом, фазовая визуализация может предоставить уникальную информацию о том, как температура и напряжение смещения постоянного тока влияют на расположение фибрилл и ориентацию тонких полимерных пленок, как это требуется для разработки индивидуальных свойств. Поскольку фазовая визуализация работает в полуконтактном режиме, то этот метод позволяет безопасно получать изображения с высоким разрешением без непрерывного контакта кантилевера с образцом. В целом, фазовая визуализация является многообещающим инструментом в приложениях, где требуется получение изображений с высокой разрешающей способностью и отображением контрастов материала на наноуровне.
Подробные характеристики
Высокоточного атомно-силового микроскопа Park NX20
для анализа дефектов и исследования крупных образцов
Ссылки
- S. Satish, et al., Preparation and characterization of nanoscale PMMA thin films Indian Journal of Pure & Applied Physics. Vol. 52, January 2014, pp. 64-67.
- V. Korolkov, et al., Ultra-high resolution imaging of thin films and single strands of polythiophene using atomic force microscopy. Nature Communications volume 10, Article number: 1537 (2019)
- J. Brostin, Compositional Imaging of Polymers Using a Field Emission Scanning Electron Microscope with a Microchannel Plate Backscattered Electron Detector. SCANNING Vol. 17, 327–329 (1995). Received March 13, 1995 and Accepted with revision May 22, 1995.
- R. Masters, et al., Sub-nanometre resolution imaging of polymer–fullerene photovoltaic blends using energy-filtered scanning electron microscopy. Nature Communications volume 6, Article number: 6928 (2015)
- https://www.parksystems.com/images/spmmodes/standard/3_Phase-Imaging-and-Phase- Detection-Microscopy-(PDM).pdf
- J. Gunther, Introduction to Atomic Force Microscopy, March 10, 1998, ACS Group and MENs, Beckman Institute https://www.slideshare.net/joserabelo/atomic-force-microscopy-37962055