Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Измерение шероховатости поверхностей подложек с помощью атомно-силовых микроскопов промышленного класса
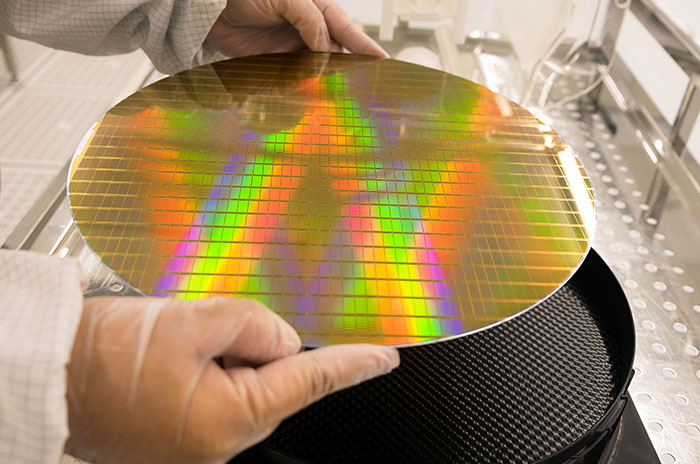
Атомно-силовая микроскопия (АСМ) идеально подходит для исследования поверхностей и характеристик различных материалов на уровне наномасштабов [1 – 6]. Высокоточное измерение шероховатости поверхности является не только очень мощным методом для понимания основ физики материалов, но также очень полезно при изучении структур различных устройств и механизмов их сбоя. Кроме того, высокая воспроизводимость измерения шероховатости является одним из очень важных факторов в промышленных сферах, так как она напрямую связана с гарантией надежности продукта для клиента. Бесконтактный режим измерения True Non-Contact компании Park Systems особенно хорошо зарекомендовал себя как метод точного измерения шероховатости поверхности с высокой воспроизводимостью.
Чтобы контролировать шероховатость с высокой точностью и хорошей воспроизводимостью, необходимо выполнить два ключевых требования. Во-первых, это поддержание остроты рабочего кантилевера, а, во-вторых, снижение шума в измерительной системе. Эти два требования рассматриваются ниже в данной статье. Кроме того, здесь продемонстрированно, почему именно бесконтактный режим True Non-Contact является мощным для точного измерения шероховатости, путем проверки остроты рабочего кантилевера и измерения ультраплоских образцов с помощью АСМ компании Park Systems.
Требования для точного измерения шероховатости поверхности
Для получения высокой воспроизводимости и точности при измерении шероховатости, первое, что нужно учитывать, – это состояние самого кантилевера. Это связано с тем, что его геометрия напрямую связана с получаемыми значениями шероховатости. Как показано на рис. 1, когда кантилевер имеет заостренную геометрию, он передает топографические свойства поверхности с высокой точностью. Но как только острие затупляется, кантилевер не может приблизиться к нижней части топографической структуры образца, поэтому он передает искаженные параметры поверхности. Вот почему по мере увеличения радиуса закругления кантилевера значение шероховатости уменьшается. Именно поэтому во время измерений шероховатости необходимо сохранять остроту кантилевера.
Рис. 1. Схематическое отображение влияния геометрии кантилевера на точность измерения шероховатости.
Уровень шумов в измерительной системе также очень важен. Причина заключается в том, что, когда сторонние шумы смешиваются с результатами измерений, АСМ не может передать данные о топографии поверхности с высокой точностью – это особенно критично при измерении ультраплоских поверхностей. Именно поэтому для обнаружения мельчайших топографических структур и элементов измеряемого образца и получения изображений высочайшего разрешения требуется низкий уровень шумов измерительной системы. Исходя из данного требования, компания Park Systems разработала атомно-силовые микроскопы, которые поддерживают минимальный в своей отрасли уровень собственного шума, составляющий менее 0.05 нм. Как показано на рис. 2а, СКО значения собственного шума у АСМ компании Park Systems обычно составляет около 0.02 нм, чего более чем достаточно для измерения ультраплоских образцов (см. рис 2б).
Рис. 2. (а) Уровень шумов, поступающих в систему от пола, которые были определены в режиме «нулевого» сканирования: когда кантилевер находится в контакте с поверхностью образца, а шумы системы измеряются в одной точке (область сканирования 0×0 нм, усиление 0.5, контактный режим измерения, разрешение 256×256 пикселей). (б) Изображение шероховатости ультраплоской поверхности, полученное с помощью атомно-слового микроскопа XE-HDM в бесконтактном режиме True Non-Contact (частота сканирования 1 Гц, разрешение 256×256 пикселей).
Точное измерение шероховатости поверхности с помощью бесконтактного режима True Non-Contact с высокой воспроизводимостью
Ниже представлены результаты проверки, как полуконтактный и бесконтактный режимы измерения влияют на геометрию кантилевера при последовательном сканировании тестового образца из CrN. Как показано на рис. 3а, бесконтактный режим позволяет получать стабильное и четкое качество изображения даже после сотого сканирования. Но при полуконтактном режиме измерения кантилевер быстро изнашивается уже после 10-го сканирования, что существенно влияет на качество получаемого изображения. Как видно из рис. 3б, острота кантилевера ухудшилась более чем на 80%, тогда как использование бесконтактного режима True Non-Contact позволило сохранить остроту кантилевера даже после получения 200-го изображения. Последующий анализ самого кантилевера показал, что при использовании полуконтактного режима его диаметр значительно изменился, так как острие постепенно затуплялось во время сканирования в виду контакта зонда с поверхностью образца.
Рис. 3. Измерение тестового образца из CrN в различных режимах сканирования. (а) Изображения, полученные в бесконтактном режиме – серия из 100 последовательных сканирований (сверху) и изображения, полученные в полуконтактном режиме – серия из 10 последовательных сканирований (снизу). (б) Диаметр острия кантилевера, рассчитанный при анализе его геометрии: данные для бесконтактного режима (слева) и полуконтактного режима (справа).
Полученные данные, представленные на рис. 4, показывают, что при сохранении остроты кантилевера, возможность измерения шероховатости с высокой точностью также сохраняется. В ходе данного теста было получено более 700 изображений одной и той же области на образце, сделанных в бесконтактном режиме с использованием одного и того же кантилевера. На выходе отслеживался параметр долговременного изменения шероховатости поверхности. Было получено среднее значение шероховатости Ra = 0.1498 нм со стандартным отклонением 1σ = 0.0024 нм (< 2% от Ra) (см. рис. 4а). Из рис. 4б видно, что высокое разрешение получаемого изображения сохранялось во время всех 752 последовательных сканирований. На рис. 4в представлен геометрический профиль острия кантилевера, полученный при анализе эталонного VLSI CD образца. Геометрия острия до и после всех измерений практически одинакова, что указывает на отсутствие заметного износа кантилевера во время измерений.
РРис. 4. Измерение поверхности образца жесткого диска в режиме True Non-Contact. (а)Отображает постоянство и воспроизводимость получаемого изображения во время 752 последовательных сканирований. (б) Промежуточные изображения, полученные в ходе данного теста.
(в) Геометрический профиль острия кантилевера до и после 752 сканирований эталонного VLSI CD образца.
Заключение
В данной статье была показана надежность бесконтактного режима анализа True Non-Contact атомно-силовых микроскопов компании Park Systems для измерения шероховатости и отображения топографии поверхности до долей нм. Было наглядно продемонстрировано, почему для измерения шероховатости поверхности требуются острота кантилевера и низкий уровень шумов системы. А проведенные тесты подтвердили, что только настоящий бесконтактный режим анализа (а не аналог в лице полуконтактного метода Tapping mode) сводит к минимуму износ кантилевера и защищает образец от повреждений, что позволяет получать изображений с высоким разрешением на протяжении более длительного периода времени. Из данных наблюдений можно сделать вывод, что бесконтактный режим анализа True Non-Contact АСМ компании Park Systems обладает уникальными особенностями, что открывает большие возможности исследования как в промышленной , так и в научной сферах.
Подробные характеристики атомно-силового микроскопа Park NX-HDM/XE-XDM
Ссылки
- G. Binning, C. Quate, and C. Gerber, Phys. Rev. Lett. 56, 930 (1986)
- D. R. Baselt and J. D. Baldeschwieler, Rev. Sci. Instrum. 64, 908 (1993)
- P. K. Hansma, B. Drake, D. Grigg, C. B. Prater, F. Yashar, G. Gurley, V. Eligns, S. Feinstein, and R. Lal, J. Appl. Phys. 76, 796 (1994)
- R. Barrett, Rev. Sci. Instrum. 62, 1393 (1991)
- K. Nakano, Rev. Sci. Instrum. 69, 1406 (1998)
- J. Kwon, J. Hong, Y. S. Kim, D. Y. Lee, K. Lee, S. M. Lee, and S. I. Park, Rev. Sci. Instrum. 74, 4378 (2003)