Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Измерения поверхностного потенциала двумерных материалов в высоком вакууме
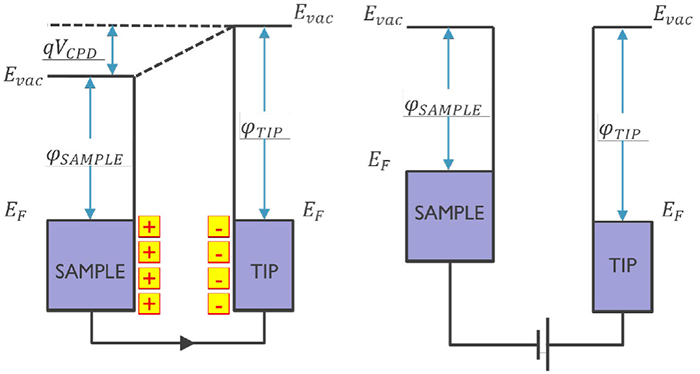
Введение
С масштабированием обычных полевых транзисторов (FET) становится все более важным преодоление неблагоприятных эффектов короткого канала. Здесь двумерные (2D) материалы, которые удерживают носители в одной плоскости, могут улучшить управление электростатическим затвором и еще больше расширить закон Мура. Среди двумерных материалов дихалькогениды переходных металлов (TMD) состоят из одного слоя переходных металлов M, зажатого между двумя слоями атомов халькогена X, образуя химическую формулу MX2. MoS2, WS2, MoSe2 и WSe2, которые являются обычными TMD, обладают полупроводниковыми свойствами благодаря своей структуре кристаллической решетки. Их монослои имеют прямую запрещенную зону и могут демонстрировать выдающиеся электрические, оптические и механические характеристики материала. В настоящее время проводятся обширные исследования TMD, поскольку ожидается огромное влияние в области нано- и оптоэлектроники, а также в производстве новых устройств.
Из-за низкой внеплоскостной проводимости и склонности к легкому разрыву характеризация однослойных или немногослойных TMD может быть сложной задачей. Лишь несколько методов, таких как комбинационное рассеяние света (рамановская спектроскопия), фотолюминесцентная спектроскопия и атомно-силовая микроскопия (АСМ), могут предоставить необходимую информацию о структурных и электронных свойствах за короткий промежуток времени. В дополнение к статистическому анализу шероховатости TMD и высоты ступеней слоя с помощью АСМ, силовая микроскопия с зондом Кельвина (KPFM) на основе АСМ все чаще используется для визуализации эффектов заряда в системах «2D материал/подложка», переноса заряда зонда в 2D/2D гетероструктурах и границах зернистости [1, 2, 3].
KPFM позволяет характеризовать электронные свойства поверхностей и устройств на наноуровне. Метод в основном используется для отображения распределения поверхностного потенциала на проводящих и полупроводниковых материалах путем измерения контактной разности потенциалов (VCPD) между зондом АСМ и образцом [4]. Таким образом, этот метод может собирать информацию о работе выхода, неоднородностях материала, локальных захваченных зарядах, встроенных наноструктурах, взаимосвязанных неисправностях и т. д. [5, 6]. Когда проводящий зонд АСМ электрически соединен с проводящим или полупроводниковым образцом, уровни Ферми кантилевера и образца выравниваются. Следовательно, электроны перетекают из материала с более низкой работой выхода в материал с более высокой работой выхода, пока не будет достигнуто состояние равновесия (т.е. уровни Ферми не выровнены). Перераспределение зарядов на двух поверхностях создает электростатическую силу между острием зонда и образцом, которая пропорциональна различию их работы выхода. Чтобы свести на нет эту электростатическую силу, между кантилевером и образцом прикладывается внешнее напряжение смещения постоянного тока – так называемая контактная разность потенциалов VCPD [1]. Она определяется как:
где φTIP и φSAMPLE – работа выхода зонда и образца соответственно, e – элементарный заряд.
Рис. 1. Диаграммы выравнивания зон электрически соединенной системы «кантилевер-образец» с нулевым напряжением смещения постоянного тока слева и с напряжением смещения постоянного тока, равного -VCPD справа. Эта схема действительна только для функций выхода φSAMPLE ≠φTIP , приводящих к ненулевому электрическому полю между зондом и образцом. EF – энергия уровней Ферми, Evac – энергия вакуумного уровня.
Как динамический метод АСМ, KPFM может работать в режиме амплитудной модуляции или в режиме боковой полосы (применимо для АСМ компании Park Systemss). В KPFM режиме боковой полосы VCPD зависит от градиента электростатической силы, а не от дальнодействующей электростатической силы, что способствует высокой электрической чувствительности и пространственному разрешению, которое в основном ограничено радиусом острия зонда. Аналитические расчеты показали, что для геометрии острия коммерчески доступного кантилевера на плоской поверхности может быть достигнуто пространственное разрешение до 10 нм [7]. Для лучшего понимания принципа KFPM мы обратимся к примечаниям по применению «Измерение контактной разности потенциалов поверхности методом SKPM» от Hosung Seo, Dan Goo и Gordon Jung, Park Systems Corporation, а также к «Surface Potential Imaging via Sideband Kelvin Probe Force Microscopy» от Armando Melgarejo, Ben Schoenek and Byong Kim, Park Systems, Inc.
Чтобы получить надежные и количественные измерения поверхностного потенциала на TMD с помощью KPFM боковой полосы, крайне важно учитывать восприимчивость материалов к изменениям поверхности образца под действием газов. В будущем изменения свойств TMD из-за их поверхностной реактивности можно будет использовать даже для приложений обнаружения молекул. В данной статье прямое сравнение поверхностного потенциала MoS2 в условиях окружающей среды и высокого вакуума в NX-Hivac компании Park Systems подчеркивает влияние газов на поверхность образца и показывает необходимость контроля окружающей среды для количественной характеристики TMD.
Эксперимент
KPFM боковой полосы позволяет измерять поверхностный потенциал, сводя на нет градиент электростатической силы, образующийся между поверхностью образца и металлическим кантилевером АСМ посредством быстрой обратной связи по постоянному току. В нашей установке модели NX-Hivac от компании Park Systems образец заземлен, и обычно прикладывается напряжение смещения переменного тока от 0.5 В до 3.0 В с частотой в диапазоне 2 – 5 кГц для модуляции электростатического сигнала. Типичная частота сканирования для измерений KPFM находится в диапазоне от 0.1 Гц до 0.3 Гц. Для этого набора данных использовались имеющиеся в продаже Si АСМ-зонды с покрытием из золота с жесткостью пружины k ≈ 5 Н/м и собственной частотой f0 ≈ 150 кГц.
Результаты
В этом эксперименте поверхностный потенциал хлопьев MoS2, перенесенных на SiO2, был исследован методом KPFM с боковой полосой в воздухе и высоком вакууме (≈ 10-5 Торр) с использованием АСМ NX-Hivac. Наблюдалась значительная разница в распределении поверхностного потенциала на хлопьях для обоих типов условий окружающей среды.
Рис. 2. Карты поверхностного потенциала хлопьев MoS2, перенесенных на подложку SiO2 на воздухе (A) и в высоком вакууме (B) с соответствующей топографией, а также графики поверхностного потенциала вдоль области поперечного сечения, обозначенной пунктирной белой рамкой.
Как показано на карте топографии на рис. 2, хлопья MoS2 не были равномерно перенесены на подложку SiO2, но в некоторых областях наблюдались сгибы и неровности, обозначенные белой и синей стрелками соответственно. При анализе распределения поверхностного потенциала это важно учитывать, поскольку известно, что толщина слоя и локальная деформация влияют на поверхностный потенциал в двумерных материалах. В окружающей среде на воздухе наблюдалась разность поверхностных потенциалов ≈0.15 В между перенесенными хлопьями MoS2 и подложкой SiO2 (рис. 2A) с меньшей величиной для последней. При измерении в высоком вакууме эта разница была значительно увеличена до значения ≈0.4 В (рис. 2B). Небольшая разность потенциалов, измеренная между хлопьями MoS2 и SiO2 на воздухе, скорее всего, может быть связана с наличием поверхностного слоя воды толщиной до 2 нм и/или кислорода, который изменяет поверхностный потенциал хлопьев MoS2 за счет переноса заряда и, впоследствии, меняет свою рабочую функцию. Кроме того, важно учитывать, что из-за различий в смачиваемости MoS2 и SiO2 экранирование фактического поверхностного потенциала путем изменения толщины слоя воды может привести к ошибке в измерениях KPFM. В условиях высокого вакуума выявлено больше деталей и контрастных инверсий поверхностного потенциала, поскольку исключается влияние воды и/или кислорода. Например, падение поверхностного потенциала на сгибах хлопьев MoS2 присутствовало в обоих экспериментах, но только в высоком вакууме было обнаружено её окружение более высокопотенциальной границей. Четкое представление о распределении потенциала, возникающем в неровностях и вокруг них, может обеспечить лучшее понимание их влияния на текущие транспортные свойства устройства. Этот эксперимент выдвигает на первый план препятствия в изучении внутренних электронных свойств двумерных материалов и оценке истинного поверхностного потенциала при измерении в воздухе.
Заключение
Данное исследование демонстрирует важность высокого вакуума для надежной и точной характеристики поверхностного потенциала 2D-материалов с использованием KPFM. Поверхностный потенциал однослойных или немногослойных MoS2 в условиях окружающей среды на воздухе значительно отличается от значений, полученных в условиях высокого вакуума: при переходе от анализа на воздухе к среде с высоким вакуумов в АСМ NX-Hivac разность поверхностных потенциалов между хлопьями MoS2 и подложкой SiO2 увеличивается от 0.15 В до 0.4 В. Небольшая разность потенциалов, наблюдаемая на воздухе, свидетельствует о наличии тонкого поверхностного слоя воды, экранирующего истинный поверхностный потенциал образца. В условиях вакуума молекулы воды со временем десорбируются. Следовательно, их влияние на электронные свойства 2D-материалов резко снижается, что обеспечивает более надежное и точное измерение поверхностного потенциала.
Подробные характеристики
Высоковакуумного атомного-силового микроскопа для анализа отказов Park NX-Hivac
Ссылки
- Datta et al. Nano Letters 9, pp. 7-11 (2008)
- Sharma et al. Appl. Phys. Lett. 110, 061602 (2017)
- Moore et al. npj 2D Materials and Applications (2020)
- M. Nonnenmacher, M. P. O’Boyle, and H. K. Wickramasinghe, Appl. Phys. Lett. 58, 2921 (1991)
- C. Barth et al 2010 New J. Phys. 12 093024
- S. Sadewasser, T.Glatzel, Kelvin probe force microscopy, Vol. 65, Springer Series in Surface Sciences
- J. Colchero, A. Gil and A. M. Baro, Phys. Rev. B, 64, 245403 (2001)