Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Анализ распределения носителей заряда в высоком вакууме с помощью сканирующей микроскопии сопротивления растеканию (SSRM) и сканирующей емкостной микроскопии (SCM)
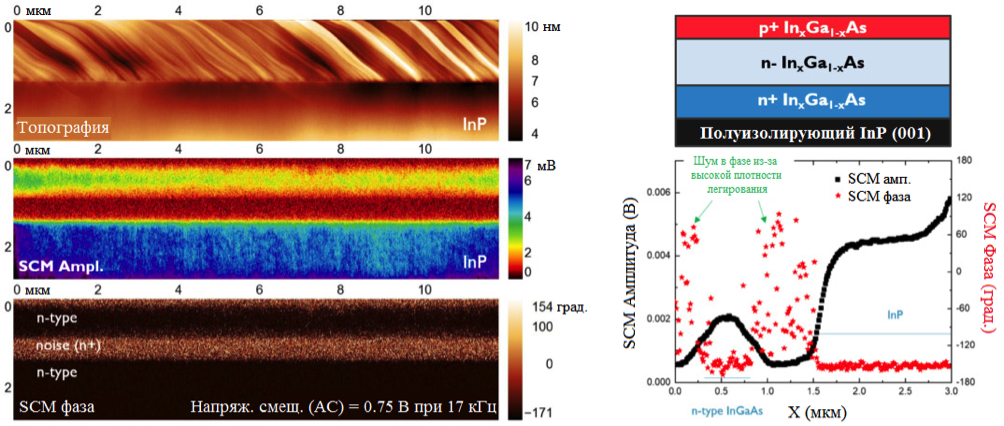
Lennaert Wouters1, Albert Minj1,2, Umberto Celano1, Thomas Hantschel1, Wilfried Vandervorst1,2, Kristof Paredis1
1 MEC, Leuven, Belgium
2Department of Physics and Astronomy, University of Leuven, Leuven, Belgium
Сканирующая микроскопия сопротивления растеканию (SSRM) и сканирующая емкостная микроскопия (SCM) являются признанными методами сканирования на основе атомно-силовых зондов для анализа распределения носителей заряда (двумерное профилирование). Первоначальное развитие данных методов было в основном продиктовано микроэлектронной промышленностью, которая искала альтернативные решения 2D анализа на замену своих одномерных методов профилирования зарядов/легирующей примеси, таких как измерения ёмкостного напряжения (C-V), масс-спектрометрия вторичных ионов (SIMS) и профилирование сопротивления сканирования (SRP).
В SSRM методе при сканировании измеряется сопротивление тока, распространяющегося через наноконтакт между кантилевером и образцом. Ключом к большой чувствительности и пространственному разрешению метода является наличие металлического кармана под давлением под вершиной острия кантилевера, что приводит к (практически) омическому контакту «образец-кантилевер». В результате в измеренном сопротивлении преобладает сопротивление растеканию и, следовательно, оно зависит от локального удельного сопротивления образца p:
где a – это площадь контакта.
Основные преимущества SSRM включают очень высокое пространственное разрешение (≈ 1 нм) и большую чувствительность и динамический диапазон (1014 – 1020 см-3).
В SCM методе небольшие изменения емкости (≈ 10-21 Ф) между кантилевером и образцом измеряются с помощью высокочастотного емкостного датчика при сканировании зондом. Области с высокой степенью легирования показывают низкую дифференциальную емкость dC/dV, в то время как области с низкой степенью легирования показывают относительно большее изменение емкости. Основными преимуществами SCM являются большой динамический диапазон и чувствительность к типу носителя заряда, поскольку n- и p-типы характеризуются противоположными фазами своих dC/dV сигналов.
В обоих методах анализа преобразовать измеренные значения непосредственно в количественные данные для носителей заряда непросто, поскольку отсутствует подробная информация о кантилевере и поверхности образца. Следовательно, калибровка по известному стандарту, как правило, является наиболее простым способом преобразования сопротивления / дифференциальной емкости в удельное сопротивление / концентрацию носителей заряда.
На самом деле, обе методики имеют свои плюсы и минусы, но являются довольно взаимодополняющими: SSRM обеспечивает самое высокое пространственное разрешение, а SCM обеспечивает чувствительность по типа заряда.
Поскольку современные электронные устройства имеют характерные структуры размерами порядка 10 нм, то и требования к изучению их характеристик выдвигаются до таких же пределов, что требует оптимизации каждого аспекта измерения для успешного анализа, например, кантилевера, пробоподготовки и среды измерения.
В данной статье рассматривается производительность атомно-силового микроскопа NX-Hivac компании Park Systems [1] для анализа методами SSRM и SCM на примере следующих трех образцов:
- Калибровочный образец легированного кремния p-типа (imec CS08-SiB), состоящий из различных слоев эпитаксиального кремния, легированных бором (≈ 600 нм) с известной концентрацией легирования.
- Калибровочный образец легированного кремния n-типа (imec CS01-SiAs), состоящий из различных слоев эпитаксиального кремния, легированных мышьяком, с известной концентрацией легирования. Данный образец дополнительно имеет легированный слой p-типа, встроенный в стек.
- Углубленный оксид, толщиной 0.5 нм, помещенный между слоем кремния с высокой степенью легирования и слоем поликристаллического кремния.
Измерения образцов проводились с помощью высоковакуумного атомно-силового микроскопа NX-Hivac в условиях высокого вакуума (≈ 5 × 10-5 мбар) с использованием imec Full Diamond кантилеверов [2].
SSRM – основы производительности
Во-первых, калибровочный образец p-типа измерялся для исследования воспроизводимости SSRM измерений. Рисунок 1 показывает, что превосходная воспроизводимость достигается при SSRM измерениях на кремнии. Обратите внимание, что воспроизводимость лучше в сильно легированных слоях. Стоит отметить, что при идентичных параметрах сканирования на воздухе, как правило, достигается воспроизводимость всего в 15 – 20% относительно вакуума, подчеркивая особое значение высокого вакуума [3].
Рис. 1. SSRM измерение калибровочного образца легированного кремния p-типа в вакууме (слева). Данные сопротивления вдоль соответствующих линий сечения (одно сканирование, цветные линии) и их усредненное значение (черная линия) (справа). Воспроизводимость отображена фиолетовой кривой.
Во-вторых, для оценки разрешения SSRM измерялся образец углубленного оксида. Рисунок 2 демонстрирует, что слой оксида толщиной 0.5 нм, встроенный в кремний, можно легко наблюдать при SSRM измерениях как результат увеличения сопротивления. Удвоение сопротивления на тонком оксиде указывает на то, что радиус электрического контакта сопоставим с толщиной оксида, что подчеркивает разрешение в доли нанометров [2].
Рис. 2. SSRM измерение с высоким разрешением углубленного оксида, толщиной 0.5 нм, помещенного между слоем кремния с высокой степенью легирования и слоем поликристаллического кремния (слева). Данные сопротивления вдоль соответствующей линии сечения за одно сканирование (справа).
И, наконец, в-третьих, калибровочный образец p-типа измерялся на воздухе и в вакууме одним и тем же зондом, чтобы проверить преимущества выполнения SSRM измерений в условиях высокого вакуума. Результаты представлены на рисунке 3: как и ожидалось, чтобы получить изображение аналогичного качества, приложенное усилие к кантилеверу, необходимое для хорошего электрического контакта острия с образцом, необходимо было увеличить почти на 50% при переходе от вакуума к обычной окружающей среде. Это наблюдение предполагает, что металлический карман под вершиной острия создается при более низком давлении в вакууме по сравнению с воздухом. Следовательно, измерения в условиях вакуума могут выполняться с меньшим усилием, прилагаемым к кантилеверу, что приводит к меньшему износу зонда и, следовательно, к более высокому разрешению [2].
Рис. 3. SSRM измерение калибровочного образца легированного кремния p-типа в условиях вакуума и на воздухе одним и тем же зондом (слева). Данные сопротивления вдоль соответствующих линий сечения за 50 сканирований (справа).
Из результатов, представленных выше, можно сделать вывод, что воспроизводимость и разрешение SSRM измерений, выполненных на АСМ NX-Hivac, отвечают современным требованиям, и что условия высокого вакуума в измерительной камере полезны для проведения экспериментов с высокой степенью повторяемости.
SSRM – измерения и калибровка
В целом, калибровочные образцы позволяют преобразовать карту сопротивления неизвестного образца в карту концентрации носителей заряда. Для этого калибровочный образец измеряется с теми же зондом и параметрами сканирования, что и при измерении интересующего образца. В качестве примера на рисунке 4 показаны карты сопротивления и концентрации носителей заряда легированного кремниевого слоя n-типа в солнечном элементе.
Рис. 4. SSRM карты сопротивления (слева) и концентрации носителей заряда (справа) легированного кремниевого слоя n-типа в солнечном элементе.
Карта концентрации носителей заряда рассчитывается по карте сопротивления с использованием калибровочной кривой, показанной на рисунке 5. Точки данных сопротивления взяты из средних значений сопротивления, измеренных для 5 слоев с известными уровнями легирования. Калибровочная кривая получается путем интерполяции этих точек данных.
Рис. 5. SSRM измерение калибровочного образца легированного кремния n-типа (слева). Данные сопротивления вдоль соответствующей линии сечения за 50 сканирований (посередине). Определение зависимости сопротивления от степени легирования, полученные из средних значений сопротивления, измеренных для 5 слоев с известными уровнями легирования калибровочного образца (справа).
Можно сделать вывод, что хорошая воспроизводимость измерений, как для образца, так и для калибровочного стандарта позволяет точно определять концентрацию активного носителя заряда в образце с неизвестными уровнями легирования.
SCM
Для оценки производительности SCM на NX-Hivac использовался калибровочный образец легированного кремния n-типа. Данный образец дополнительно имеет легированный слой p-типа, встроенный в стек (между подложкой и n-слоями).
На рисунке 6 представлены карты амплитуды и фазы dC/dV сигналов, соответственно, полученные из измерения SCM на калибровочном образце n-типа. Из фазовой карты можно четко различить n- и p-слои. Различные слои n-типа с различными концентрациями легирования также показывают четкий контраст на карте амплитуды. Эти результаты демонстрируют чувствительность SCM метода к концентрации носителей заряда и его способность восприятия типа заряда, хотя пространственное и разрешение не такое хорошее, как для SSRM метода.
Рис. 6. Измерение амплитуды и фазы dC/dV сигналов калибровочный образец легированного кремния n-типа (слева). Данные амплитуды dC/dV сигнала вдоль соответствующей линий сечения за 50 сканирований (справа).
Помимо анализа кремний еще одним интересным применением SCM метода является анализ стеков из полупроводниковых материалов III-V типа. На рисунке 7 показаны результаты SCM измерения на легированном стеке InGaAs, которые позволяют извлечь информацию о концентрации носителей заряда и их типе.
Рис. 7. SCM измерения легированного стека InGaAs (слева). Данные амплитуды и фазы dC/dV сигналов сигнала вдоль линий сечения за 100 сканирований (справа).
Заключение
Исследование показало, что сканирующая микроскопия сопротивления растеканию (SSRM) и сканирующая емкостная микроскопия (SCM) могут решить проблемы двумерного профилирования носителей заряда в современных электронных устройствах, имеющих характерные структуры размерами порядка 10 нм, при условии выбора правильного инструмента для анализа. Предоставленные результаты говорят о том, что АСМ NX-Hivac является мощным инструментом, который помогает решать возникающие проблемы постоянно уменьшающихся устройств благодаря внедрению таких электрических режимов зондовой микроскопии, как SSRM и SCM в условиях высокого вакуума. Кроме того, мы пришли к выводу, что использование высокого вакуума в NX-Hivac значительно помогает уменьшить шум, в результате чего средняя воспроизводимость измерений составляет 6.1% для SSRM метода.
Подробные характеристики
Высоковакуумного атомно-силового микроскопа Park NX-Hivac
Ссылки
- Park NX-Hivac, Retrieved from https://parksystems.com/products/small-sample-afm/park-nx-hivac?highlight=WyJueC1oaXZhYyIsIm54LWhpdmFjJ3MiXQ
- Hantschel, T., et al. Diamond scanning probes with subnanometer resolution for advanced nanoelectronics device characterization, Microelectronic Engineering 159, 46-50 (2016).
- Eyben, P. et al. Fundamentals of Picoscience, Subnanometer Characterization of Nanoelectronic devices. Edited by Sattler, K.D., CRC Press (2014)


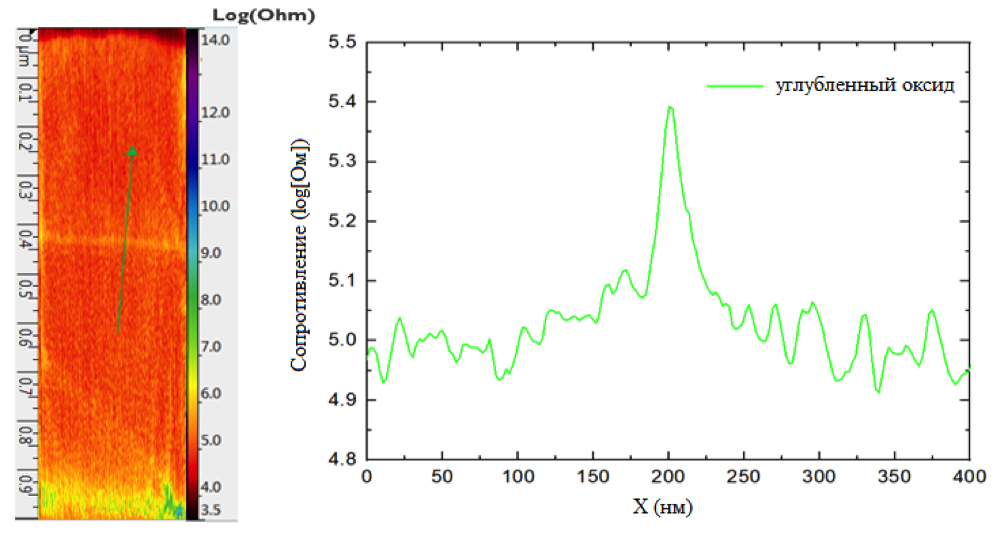

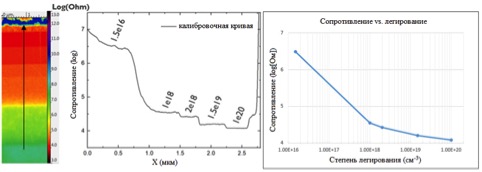

 Подробные характеристики
Подробные характеристики