Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Исследование улучшенного обнаружения поверхностного потенциала с помощью FM-KPFM
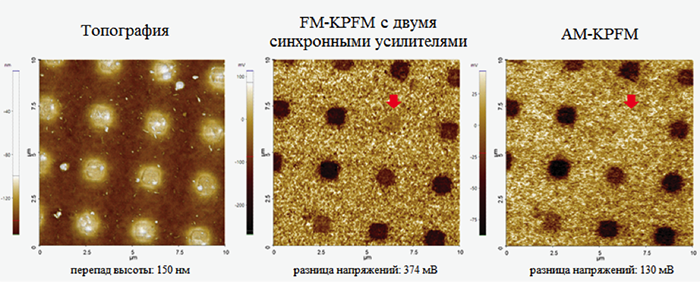
Кельвин-зондовая силовая микроскопия (KPFM) – это метод, используемый для измерения работы выхода и локального распределения электрического потенциала различных материалов на уровне наномасштабов. Наиболее частое использование данного метода приходится на изучение электрических свойств полупроводниковых наноструктур и поверхностей. Основная задача – это профилирование электрического потенциала компонентов, представляющих собой положительно и отрицательно заряженные области. В некоторых случаях такие измерения могут быть выполнены с нанометровым горизонтальным разрешением. Внедрение такого метода для раскрытия изменений распределения заряда, происходящих на наноуровне, может помочь лучше понять и улучшить производительность КМОП-полупроводниковых приборов [1, 2]. Также KPFM играет важную роль в получении характеристик и определении количественной физической информации, такой как общее распределение заряда и положение заряда в полимерных материалах [3, 4].
Существуют также и другие инструментарии для измерения работы выхода и поверхностного потенциала, такие как измерение тока, индуцированного электронным пучком (EBIC), растровая электронная микроскопия (SEM) и фотоэлектронная спектроскопия (PES). Однако некоторые из этих методов применимы только для неорганических типов полупроводников, другие являются разрушающими и работают только при высоком вакууме, а третьи не обеспечивают необходимого пространственного разрешения. По сравнению с другими методами, KPFM представляет собой неразрушающий метод и работает в условиях нормальной окружающей среды, однозначно являясь одним из самых простых в использовании нанометрологических инструментов для анализа электрических отказов, доступных на мировом рынке на сегодняшний день [5].
Стандартная KPFM технология (также известная как Кельвин-зондовая силовая микроскопия с модуляцией по амплитуде (AM-KPFM)) уже внесла значительный вклад в поддержание надежности устройств и анализ передовых материалов по сравнению с другими измерительными методами. Однако имеется возможность улучшения обнаружительной способности AM-KPFM за счет оптимизации отношения сигнал/шум, что позволяет проводить анализ более слабых поверхностных потенциалов и отображать их с более высокой точностью и разрешением. С этой целью компания Park Systems недавно разработала методику частотной модуляции для Кельвин-зондовой силовой микроскопии (FM-KPFM) с использованием атомно-силовых микроскопов. Данный метод улучшает анализ электрических характеристик, позволяя проводить измерения с более высокой чувствительностью по сравнению с AM-KPFM.
В данной статье описано измерение полимерного материала для сравнения производительности AM-KPFM и FM-KPFM методов. Результаты, полученные в ходе эксперимента, показали, что FM-KPFM является гораздо более чувствительной, чем AM-KPFM, как при измерении работы выхода, так и при анализе распределения поверхностного потенциала различных материалов.
Эксперимент
В данном эксперименте исследовался полимерный структурированный массив, нанесенный на кремниевую подложку, с помощью атомно-силового микроскопа модели NX10 компании Park Systems. Было произведено два отдельных сканирования для измерений методами AM-KPFM и FM-KPFM. Параметры сканирования и рабочий кантилевер были идентичными при обоих измерениях. Использовался проводящий кантилевер модели NSC36Cr-Au компании Mikromasch (номинальный коэффициент жесткости k = 1 Н/м; резонансная частота f = 90 кГц).
В режиме KPFM имеют место два типа сил взаимодействия между образцом и кантилевером, с приложенным к нему напряжением смещения переменным током: электростатическая сила и сила межатомного взаимодействия (силы Ван-дер-Ваальса). Силы Ван-дер-Ваальса используются для получения топографии поверхности образца, тогда как электростатическая сила между кантилевером и образцом позволяет исследовать электрические свойства. В сигнале, получаемом при отклонении кантилевера во время сканирования, содержатся сигналы об обеих силах – метод, который позволяет полностью разделить эти сигналы, является ключевым для успешной визуализации. В АСМ NX10 синхронные усилители, встроенные в модуль управляющей электроники, используются как раз для разделения подобных сигналов – это позволяет одновременно получать данные о топографии и электрических свойствах. Обычно используется два синхронных усилителя – lock-in 1 и lock-in 2. Lock-in 1 усилитель собирает данные о топографии путем анализа движения кантилевера, вызванного силами Ван-дер-Ваальса, тогда как lock-in 2 усилитель собирает электрическую информацию путем анализа частоты колебаний приложенного напряжения смещения переменным током, которое, в свою очередь, генерирует электростатическое взаимодействие с образцом. Частота прикладываемого напряжения смещения выбирается достаточно малой (5 – 20 кГц) по сравнению с частотой колебаний кантилевера (70 – 330 кГц), поэтому два регистрируемых сигнала не влияют друг на друга. В FM-KPFM установке [6] фазовый сигнал усилителя lock-in 1 переносится на усилитель lock-in 2, чтобы служить источником для работы EFM, путем подключения BNC кабеля между выходом Aux 2 out и входом Aux 1 in (см. рис. 1). Кроме того, к кантилеверу дополнительно было приложено напряжение смещения постоянным током и контролировалось для создания механизма обратной связи, необходимого для обнуления электрических колебаний между кантилевером и образцом, вызываемых приложением переменного тока. Величина данного смещающего напряжения постоянного тока и считалась мерой поверхностного потенциала.
Рис. 1. Диаграмма FM-KPFM.
Результаты и выводы
Топографические данные, полученные в ходе эксперимента, показывают, что полимерный структурированный массив с квадратно-образной структурой был успешно нанесен на кремниевую подложку, но никаких данных о поверхностном потенциале полученное изображение не несет. AM-KPFM и FM-KPFM изображения, наоборот, отображают информацию о распределении потенциала по поверхности, но не отображают никаких топографических данных. Форма доменных структур, наблюдаемых на KPFM изображениях, схожа с физической структурой массива на топографическом изображении, которая и представляет собой структурированный массив, состоящий из квадратных областей. Все данные, полученные в ходе эксперимента, были обработаны с помощью программы XEI компании Park Systems, которая позволяет транслировать полученные данные в изображения. На рисунке 2 представлены изображения топографии (слева), FM-KPFM (посередине) и AM-KPFM (справа). Данные о топографии могут быть получены одновременно с данными KPFM. В данном случае изображение топографии было получено одновременно с AM-KPFM изображением. Топографическое изображение показывает четкую и хорошо упорядоченную структурную решетку нанесенного полимера. Здесь квадратные доменные структуры отображены в виде более светлых областей, что говорит об их большей высоте, тогда как плоские области темного цвета отображают зоны с низкой высотой. Измеренное значение перепада между максимумом и минимумом топографической структуры составило порядка 150 нм. С другой стороны, оба KPFM изображения отображают массив с наличием дефекта (отмечен красной стрелкой). Здесь квадратные доменные структуры отображены в виде более темных областей, что говорит об их относительно низком поверхностном потенциале, тогда как плоские области светлого цвета отображают зоны высокого потенциала. Сравнивая AM-KPFM и FM-KPFM изображения, легко можно заметить, что FM-KPFM метод имеет более высокую чувствительность регистрации поверхностного потенциала, чем AM-KPFM метод. В данном эксперименте доменные структуры на FM-KPFM изображении отображены с более четкими границами. Кроме того, данный метод смог зарегистрировать слабый поверхностный потенциал с области дефекта, тогда как AM-KPFM метод вообще не увидел никаких изменений.
Рис. 2. Изображение области 10×10 мкм полимерного структурированного массива. Изображения топографии (слева), FM-KPFM (посередине) и AM-KPFM (справа).
На рис. 3 представлен профиль распределения поверхностного потенциала (снизу) вдоль линии сечения. Линия сечения для FM-KPFM отображена красным цветом, а для AM-KPFM – зеленым цветом. Профиль линии для FM-KPFM изображения четко показывает, что в области дефекта есть слабое уменьшение потенциала (выделено красным), но не такое сильное, как для других доменных структур. Профиль же линии для AM-KPFM изображения вообще не показывает никаких изменений в потенциале для дефектной области. Таким образом, сравнивая эти два метода Кельвин-зондовой силовой микроскопии, можно сделать вывод, что FM-KPFM метод с частотной модуляцией как минимум на один порядок величины чувствительнее стандартного AM-KPFM метода с амплитудной модуляцией.
Рис. 3. FM-KPFM изображение (вверху слева) и AM-KPFM изображение (вверху справа), а также профиль линии распределения потенциала (снизу) вдоль соответствующей линии сечения.
Заключение
Полимерный структурированный массив был успешно исследован с помощью атомно-силового микроскопа NX10 компании Park Systems с использованием FM-KPFM и AM-KPFM методов. Топографическое изображение показало, что поверхность образца представляет собой доменный структурированный массив, состоящий из квадратных областей. На обоих KPFM изображениях была видно область с дефектом: FM-KPFM метод показал, что данная область обладает слабым поверхностным потенциалом, тогда как AM-KPFM метод не был достаточно чувствительным для регистрации такого слабого сигнала в той же области. Анализируя полученные результаты, можно утверждать, что FM-KPFM метод с частотной модуляцией как минимум на один порядок величины чувствительнее стандартного AM-KPFM метода с амплитудной модуляцией и является более пригодным для регистрации перепадов распределения поверхностного потенциала различных полупроводниковых материалов и устройств. Кроме того, повышенная чувствительность данного метода увеличивает шансы регистрации даже незначительных дефектов, отображая их с большей точностью и разрешением.
Подробные характеристики сканирующего атомно-силового микроскопа Park NX10
Ссылки
- LanFei (2018) FUNDAMENTALS OF KELVIN PROBE FORCE MICROSCOPY AND ITS APPLICATIONS IN THE CHARACTERIZATION OF SOLAR CELLS. Doctoral Dissertation, University of Pittsburgh.
- J.Pineda, et al., Electrical Characterization of Semiconductor Device Using SCM and KPFM Imaging.
- J. Gonzalez, et al., Charge distribution from KPFM images, PCCP, Issue 40, 2017.
- M. Ortuño, et al., Conducting polymers as electron glasses: surface charge domains and slow relaxation, Scientific Reports volume 6, Article number: 21647 (2016).
- W. Melitz, et al., Kelvin probe force microscopy and its application, Surface Science Reports 66 (2011) 1–27.
- Charles Kim, et al., How to Measure FM-KPFM, Park Systems.