Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Спектроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: Раздел: Атомно-силовая микроскопия
Автор: ГалинаРаздел: Анализ микроструктуры материалов
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Автор: ВикторРаздел: Атомно-силовая микроскопия
Нажимая кнопку «Подписаться», вы принимаете условия «Соглашения на обработку персональных данных».
Анализ топографии структурированной сапфировой подложки для сине-зеленых LED диодов
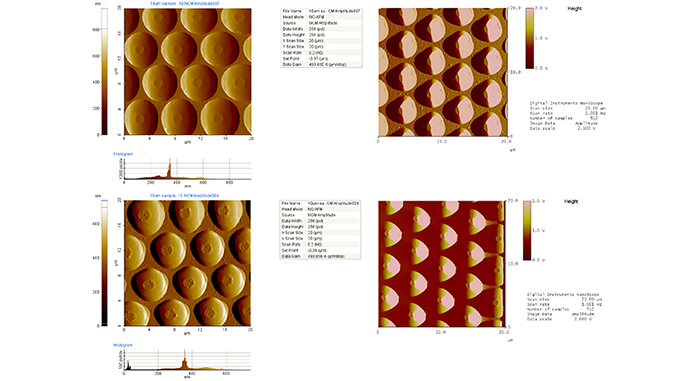
Введение
Полупроводниковые материалы на основе азота (GaN, InGaN, AlN) в последние годы привлекаю к себе большое внимание с целью их применения в электронных и оптоэлектронных приборах и устройствах, включая сине-зеленые светодиоды (LED), лазерные диоды и твердотельные транзисторы [1]. Исследователи уже давно знают о свойствах нитридов третьей группы, включая их широкие запрещенные зоны и прочность, но так и не смогли найти подходящие тип подложек, на которых бы можно было выращивать тонкие пленки интересующих соединений.
Практический подход говорит, что используемая подложка должна иметь кристаллическую структуру, сочетающуюся с GaN (используется в качестве стандартного контакта n/p-типа), а также должна быть доступна в больших размерах и по разумной цене. Недавние достижения в технологиях эпитаксиального тонкопленочного выращивания и выборе материалов подложек позволяют частично решить данную проблему. Однако параметры кристаллической решетки сапфира, использующегося в качестве подложки большинством производителей LED, не полностью соответствуют структуре GaN (рассогласование составляет 16%), что в результате приводит к появлению кристаллических дефектов в высокой плотности (например, перегруппировка, точечные дефекты) [2].
SiC является более подходящим материалом, однако по-прежнему остается дорогостоящим, а также приводит к рассогласованию структурных границ, что значительно снижает срок службы устройства. Также большие кремниевые подложки (диаметром 100-150 мм и более) быстро становятся основным выбором производителей электронных устройств, однако даже в этих подложках все еще присутствуют эффекты рассогласования структуры, что приводит к появлению поверхностных трещин (в виду наличия внутренних напряжений) при нанесении пленок критической толщины. В дополнение, кремниевые подложки являются менее устойчивыми с механической точки зрения по сравнению с сапфиром и SiC.
Для дальнейшего повышения яркости сине-зеленых светодиодов, выращенных методом химического осаждения металлоорганических соединений и паровой фазы (MOCVD), большинство производителей азиатского региона (Япония, Корея, Тайвань, Китай) приняли методы поверхностного структурирования как для границы раздела «сапфир – эпитаксиальная пленка» (структурирование сапфировой подложки достигается за счет методов подготовки подложки), так и для границы раздела «эпитаксиальная пленка – изготовленный контакт» (придание необходимой шероховатости p-стороне достигается на этапе MOCVD).
Данные методы, при правильных подготовке и технологическом процессе, позволяют получить более высокий коэффициент испускания света из LED [3]. Для обоих методов структурирования правильная и точная информация о топографии поверхности имеет жизненно важное значение для достижения поставленных задач. Было установлено, что большинство методов традиционной микроскопии (оптическая микроскопия, сканирующая электронная микроскопия и т.п.) имеют ряд ограничений с точки зрения применимости для контроля шероховатости, получаемой вышеупомянутыми методами. Среди данных ограничений находятся недостаточное пространственное разрешение, технологически сложная пробоподготовка, проблемы с надежностью и воспроизводимостью получаемых результатов, время сканирования и т.д.
Атомно-силовая микроскопия (АСМ) предлагает простой, эффективный и неразрушающий альтернативный метод контроля для анализа различных видов поверхностей структурированных объектов как на этапах контроля сапфировых подложек, так и на конечной стадии готовых LED.
Традиционные АСМ были разработаны под использование сканирующего механизма, основанного пьезоэлектрическом трубчатом XYZ сканере. В виду данной особенности в конечные результаты измерений по умолчанию вносились сопутствующие нелинейные помехи, например, искривление поверхности, которая на самом деле является плоской.
Атомно-силовые микроскопы серии XE компании Park Systems оснащены парой независимых высокоточных сканеров: один для плоскости XY, второй для работы вдоль оси Z. Это позволило избавиться от эффектов нелинейности, а также привело к созданию уникального бесконтактного режима измерений, при котором ни поверхность образца, ни сканирующий зонд не соприкасаются друг с другом.
Обзор систем серии XE
Во всех микроскопах серии XE Z-сканер контролирует вертикальное перемещение кантилевера, который является основным рабочим элементом при получении информации о топографии. Данный сканер является независимым от второго XY-сканера, задачей которого является только перемещение исследуемого образца в горизонтальной плоскости. Именно данный подход предоставляет значительные улучшения в производительности и реализует бесконтактным режим измерения True Non-Contact. Дополнительно, усовершенствованный дизайн АСМ данной серии позволяет увеличить скорость сбора данных минимум в 10 раз по сравнению с обычными АСМ на основе пьезотрубчатых сканеров, а также минимизирует ошибки нелинейности, вызванные самим сканером. И именно за счет такого дизайна АСМ серии XE компании Park Systems обеспечивают исключительную производительность, ортогональность и точность сканирования, которые не имеют аналогов на мировом рынке (см. рис. 1).
Рис. 1. Вид сбоку на основной сканирующий модуль АСМ серии XE с независимыми сканерами.
Z-сканер разработан таким образом, чтобы его собственная резонансная частота была намного больше, чем у стандартных пьезотрубчатых сканеров. Для данной цели используется составной пьезоэлектрический актюатор. И поскольку обратный отклик сервопривода Z-сканера является очень точным, кантилевер может с легкостью следовать поверхностной структуре образца без опасности столкновения или зацепа.
XY-сканер представляет собой гибкий сканер, гарантирующий за счет своего строения высокую ортогональность сканирования с минимальными внеплоскостными отклонениями. Отклонение от плоскостности составляет всего 1 – 2 нм на области сканирования в 50 × 50 мкм, тогда как у обычных сканеров данное отклонение составляет более 80 нм для такого же диапазона сканирования.
Кроме того, симметричный дизайн типоисполнения позволяет размещать на предметном столике большие образцы по сравнению с трубчатым сканером, а также такой дизайн позволяет поддерживать равновесный баланс сканера даже при размещении на нем нового образца, в результате чего общая динамика перемещения остается неизменной. В заключение, поскольку XY-сканер перемещается только в горизонтальной плоскости, скорость его сканирования может быть увеличена до 10 – 50 Гц, что зачастую невозможно на стандартных АСМ.
Серия XE характеризуется не только инновационным дизайном, обеспечивающим высокую производительность, но также в ней используется самая современная электроника. Модуль управляющей электроники включает в себя передовые электронные цифровые схемы с различными программными и аппаратными компонентами, обеспечивающими высокую скорость и производительность обработки полученных данных. Данная особенность позволяет осуществлять эффективное, точное и быстрое управление микроскопом и упрощает оператору получение высококачественных изображений при высоких скоростях сканирования.
Помимо высокой скорости сканирования данный модуль контролирует движение кантилевера за счет механизма обратной связи с замкнутым контуром, что необходимо для сопоставления каждого другого анализируемого свойства с топографической точкой на поверхности образца.
Не смотря на то, что система может получать данные в нескольких режимах измерений, если прибор не отображает точное местоположение измеряемой точки, то для исправления данного положения (калибровки) необходима коррекция данных программным обеспечением. Коррекция топографического положения обычно хорошо работает без искажений для малых областей сканирования, тогда как в серии XE за счет механизма обратной связи коррекция может быть применена для любой области сканирования.
Исследование структурированной сапфировой подложки
На рисунке 2 ниже представлены два топографических изображения для области 20 × 20 мкм (режим True Non-Contact, амплитудный канал) различных типов структурированной сапфировой подложки (ССП), полученные с помощью атомно-силового микроскопа серии XE. На полученных изображения наблюдаются круглые структуры диаметром порядка 5 мкм и высотой около 1.7 мкм вне зависимости от направления оси анализа.
Не смотря на то, что обе подложки были изготовлены с помощью одинаковых методов, изображение 2(a) показывает гладкую структуру как самих круглых областей, так и промежутков между ними, тогда как на изображении 2(b) отчетливо видны поверхностные дефекты и/или остаточные осаждения как на структуре, так и между круглыми областями. На рисунке 3 также представлены два топографических изображения для области 20 × 20 мкм (полуконтактный режим, амплитудный канал) тех же самых образцов, но полученные на стороннем классическом АСМ с пьезоэлектрическим трубчатым сканером. Изображение 3(a) показывает ассиметричную структуру круглых областей (поскольку вдоль одной из осей сканирование было более медленным), а изображение 3(b) отображает только часть структуры.
Рис. 2. Топографические изображения двух различных сапфировых подложек (20 × 20 мкм, режим True Non-Contact, 0.2 Гц, 256 × 256 пикселей), полученные на АСМ серии XE.
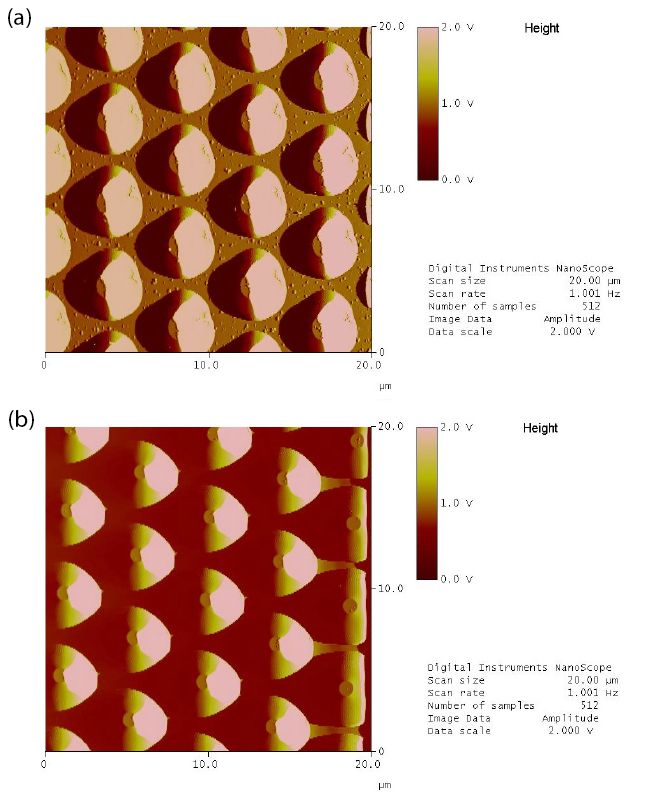
Рис. 3. Топографические изображения двух различных сапфировых подложек (20 × 20 мкм, полуконтактный режим, 1.0 Гц, 512 × 256 пикселей), полученные обычном АСМ.
Между полученными изображениями (рисунки 2 и 3) легко наблюдается ряд отличий для рис. 3:
- полученные круглые области имеют цилиндрическую структуру (более вытянуты при сканировании вдоль медленной оси)
- высота круглых областей при сканировании вдоль оси X составляет 1.5 мкм, а вдоль оси Y – 1.1 – 1.4 мкм
Единственная надежная информация, которая может быть использована после анализа изображений рис. 3. (при сравнении 3(a) и 3(b)), – это то, что на втором образце присутствуют поверхностные дефекты и/или остаточные осаждения между круглыми областями, что согласуется с рисунком 2, но не дает полной информации об исследуемых образцах.
Далее эти же образцы были исследованы с помощью метода прямой оптической микроскопии с целью подтверждения информации о форме и размерах круглых структур, полученных с помощью АСМ. Было обнаружено, что обе структурированные подложки действительно имеют круглые структуру диаметром порядка 4 – 5 мкм и высотой около 1.6 мкм, что превосходно согласуется с результатами измерений, полученными на АСМ серии XE.
Вопрос о несоответствии изображений между двумя типами АСМ по-прежнему остается актуальным. Для дальнейших исследований несколько изображений все тех же образцов были получены при различных условиях сканирования (режим True Non-Contact, 0.2 Гц; режим True Non-Contact, 1.0 Гц; полуконтактный режим, 1.0 Гц) и были построены их трехмерные модели. В ходе измерений не было произведено существенных подстроек параметров сканирования (< 20%) для различных режимов. Было показано, что даже когда АСМ серии XE работал в таком же режиме и с такими же параметрами измерений, как обычным АСМ с пьезотрубчатым сканером, полученный результат существенно отличался от того, который представлен на рис. 3(a).
В связи с этим можно сделать предварительный вывод, что при использовании АСМ с пьезосканером пользователь изначально будет тратить большое количество времени на оптимизацию параметров сканирования, чтобы получить как можно более четкое изображение. Тогда как в АСМ серии XE данный этап потребует минимального вмешательства пользователя, а большая степень автоматизации измерений позволит получать высококачественные изображения даже начинающим пользователям.
Заключение
Благодаря улучшенному коэффициенту светопередачи структурированных сапфировых подложек, используемых для изготовления для сине-зеленых LED диодов, мировые производители начинают все чаще использовать их в своих производственных линиях. Информация касаемо точной физической структуры (форма и размеры) таких подложек является жизненно важной для производителей.
Было показано, что атомно-силовая микроскопия с высокой точностью способна предоставить такую информацию и является простым и неразрушающим методом, позволяющим экономить время анализа и уменьшить необходимость в приобретении расходных материалов. К тому же данный метод исследований позволяет контролировать не только конечную продукцию, но также оценивать качество изготавливаемых подложек и технологических слоев (с точки зрения шероховатости) на всех этапах производства. Новый инновационный дизайн данных АСМ с независимыми сканерами и современная электроника позволяют данным приборам быть на несколько шагов впереди существующих стандартных АСМ с пьезосканером и предоставлять топографическую информацию о поверхности с достоверной точностью и разрешением.
Подробные характеристики атомно-силового микроскопа Park ХЕ15
Ссылки
- S. Nakamura, M. Senoh, N. Iwasa, S. Nagahama, T. Yamada, and T. Mukai, Jpn. J. Appl. Phys. Part 2 34, L1332 (1995)
- J. Nause, III-V Review 12 , 28 (1999)
- S.J. Chang, Y.K. Su, Y.C. Lin, R. W. Chuang, C.S. Chang, J.K. Sheu, T.C. Wen, S.C. Shei, C.K. Kuo, and D.H. Fang, Phys. Stat. Solidi (c) 7, 2253 (2003)